飛行時間二次離子質(zhì)譜分析(TOF-SIMS)
1. 飛行時間二次離子質(zhì)譜技術(shù)
飛行時間二次離子質(zhì)譜技術(shù)(Time of Flight Secondary Ion Mass Spectrometry,TOF-SIMS)是一種非常靈敏的表面分析技術(shù),通過用一次離子激發(fā)樣品表面,打出極其微量的二次離子,根據(jù)二次離子因不同的質(zhì)量而飛行到探測器的時間不同來測定離子質(zhì)量,具有極高分辨率的測量技術(shù)。可以廣泛應(yīng)用于物理,化學(xué),微電子,生物,制藥,空間分析等工業(yè)和研究方面。TOF-SIMS可以提供表面,薄膜,界面以至于三維樣品的元素、分子等結(jié)構(gòu)信息,其特點在二次離子來自表面單個原子層分子層(1nm以內(nèi)),僅帶出表面的化學(xué)信息,具有分析區(qū)域小、分析深度淺和不破壞樣品的特點,廣泛應(yīng)用于物理,化學(xué),微電子,生物,制藥,空間分析等工業(yè)和研究方面。
2. 飛行時間二次離子質(zhì)譜分析(TOF-SIMS)可為客戶解決的產(chǎn)品質(zhì)量問題
(1)當(dāng)產(chǎn)品表面存在微小的異物,而常規(guī)的成分測試方法無法準(zhǔn)確對異物進行定性定量分析,可選擇TOF-SIMS進行分析,TOF-SIMS能分析10&nm直徑的異物成分。
(2)當(dāng)產(chǎn)品表面膜層太薄,無法使用常規(guī)測試進行成分分析,可選擇TOF-SIMS進行分析,利用TOF-SIMS可定性分析膜層的成分。
(3)當(dāng)產(chǎn)品表面出現(xiàn)異物,但是未能確定異物的種類,利用TOF-SIMS成分分析,不僅可以分析出異物所含元素,還可以分析出異物的分子式,包括有機物分子式。
(4)當(dāng)膜層與基材截面出現(xiàn)分層等問題,但是未能觀察到明顯的異物痕跡,可使用TOF-SIMS分析表面痕量物質(zhì)成分,以確定截面是否存在外來污染,檢出限高達ppm級別。
3. 飛行時間二次離子質(zhì)譜分析(TOF-SIMS)注意事項
(1)樣品最大規(guī)格尺寸為1cm,1cm,0.5cm,當(dāng)樣品尺寸過大需切割取樣。
(2)取樣的時候避免手和取樣工具接觸到需要測試的位置,取下樣品后使用真空包裝或其他能隔離外界環(huán)境的包裝, 避免外來污染影響分析結(jié)果。
(3)TOF-SIMS測試的樣品不受導(dǎo)電性的限制,絕緣的樣品也可以測試。
(4)TOF-SIMS元素分析范圍H-U,包含有機無機材料的元素及分子態(tài),檢出限ppm級別。
4.應(yīng)用實例
樣品信息:銅箔表面覆蓋有機物鈍化膜,達到保護銅箔目的,客戶端需要分析分析苯并咪唑與銅表面結(jié)合方式 。
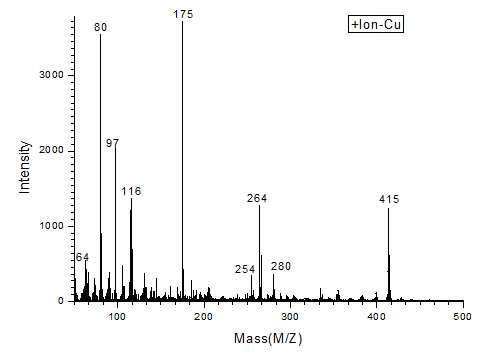

結(jié)論:正負離子譜均出現(xiàn)415和416質(zhì)量數(shù)的分子離子峰, 苯并咪唑(代號P2)分子量為175,推斷結(jié)合方式為P2-Cu-P2。









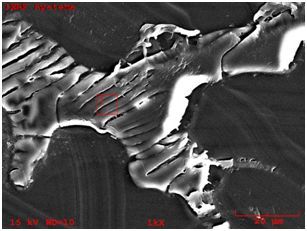







.jpg)
